ダイシングブレード3製品、ドライポリッシングホイール1製品を開発
半導体製造装置メーカー・株式会社ディスコ(本社:東京都大田区、社長:関家一馬)は、半導体・電子部品市場向けのダイシングブレード「ZHSR Series」、「TM22 Series」、「BH23 Series」、ドライポリッシングホイール「DPEG Series SZ Type」を開発しました。
本製品は、SEMICON Japan 2023(12/13-15、東京ビッグサイト)にて展示します。
シリコンウェーハダイシング向けハブブレード「ZHSR Series」
背景
近年、ロジックなどの半導体製造工程では微細化の進展により、徹底した静電気対策が求められています。ウェーハダイシング工程では冷却・洗浄のため超純水を使用しますが、不導体であるためCO2を溶解させ、導電性を持たせるのが一般的な対策です。しかし帯電量を抑える目的で超純水のCO2濃度を高めた場合に、電鋳ブレードに発生する腐食が課題でした。「ZHSR Series」は、高品位な加工を維持しつつ、耐食性向上を実現しました。

特徴
- 新ボンド材を開発
- 耐食性を大幅に改善
- ブレード先細りによる蛇行や破損を減らし、歩留まりを改善
- 自生発刃を促し、高品位加工を実現

高剛性メタルボンドブレード「TM22 Series」
背景
コンデンサなどの受動部品は、切断後チップの形状や体積が製品性能に影響を及ぼすため、寸法精度の高い加工が求められます。「TM22 Series」は、TM11の後継としてさらにボンド強度を高めることで高精度加工を実現し、生産性の向上に寄与します。

特徴
- 強度の高いボンド材を開発
- 加工後のチップ寸法精度が向上
- ブレード先細りによる蛇行や破損を減らし、歩留まりを改善
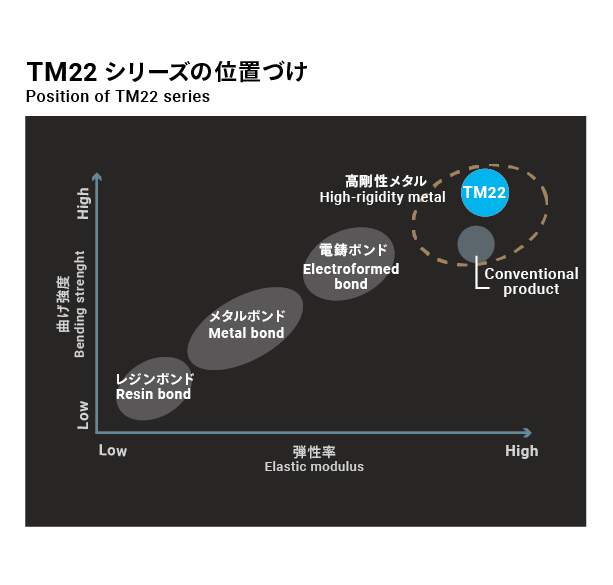
オートブレードチェンジャー(ABC)対応メタル・レジンボンドブレード「BH23 Series」
背景
シリコンウェーハの切断においてハブブレードを自動交換するABCは、オペレータのミス防止、稼働率向上に寄与し、好評を得ています。同様の自動化は、電子部品やパッケージの切断に用いられるメタル・レジンブレードにも求められてきました。「BH23 Series」は、メタル・レジンブレードにアルミ基台を接合したことでABCへの対応を実現し、自動化を促進します。

特徴
- メタル、レジンなどのボンドに対応
- ブレードの個体情報を2次元コードで基台へ印字
- 刃先出し量・ブレード厚さの実測値などを装置へ自動入力
- ブレード品種の付け間違いや数値入力ミスなどのヒューマンエラーを防止
- 使用ブレードのシリアル番号を自動で記録し、トレサビリティを確保
- オペレータの操作待ちによるダウンタイムが減少
- 装置の稼働率向上

シリコンウェーハ向けGetteringDPホイール「DPEG Series SZ Type」
背景
シリコンウェーハ薄化の際に強度を上げるためには、研削面の歪みを除去する必要がありますが、完全に除去するとゲッタリング効果※が失われ、重金属汚染によるウェーハ特性不良が生じる可能性があります。この課題に対応するGetteringDPホイールに、この度新たに加わった「DPEG Series SZ Type」は、ゲッタリング効果を維持しつつ、従来品よりも高い抗折強度を実現しています。
※ゲッタリング効果:シリコンウェーハ内部または裏面に、結晶欠陥・歪みなど(=ゲッタリングサイト)を形成し、このゲッタリングサイトに金属汚染を引き起こす不純物を捕獲・固着する技術。GetteringDPホイールは、ウェーハ裏面の微小な傷でゲッタリングサイトを形成し、重金属不純物を捕獲します。

特徴
- パッド部の組成を改良
- ゲッタリング効果を維持しつつ、チップの抗折強度を約1.3倍UP(従来品比)
今後の予定
4製品とも販売開始しております。担当営業にお問合せください。
株式会社ディスコについて
当社は、半導体や電子部品の製造に使用されるダイシングソーやグラインダなどの精密加工装置、および装置に取り付けて使用する精密加工ツールを提供する「半導体製造装置メーカー」です。これら製品に加え、装置とツールの利用技術の提供によりお客様の最適な加工結果を追求してきた結果、国内外のデバイスメーカーおよび半導体受託製造企業などに広く、当社製品・加工技術が採用されています。
詳細については、ウェブサイトwww.disco.co.jpをご覧ください。
お問い合わせ
株式会社ディスコ 広報室
