Φ8インチウェーハ対応
フルオートマチックグラインダDFG8541を開発
半導体製造装置メーカー・株式会社ディスコ(本社:東京都大田区、社長:関家一馬)は、Si(シリコン)やSiC(炭化ケイ素)など最大Φ8インチのワークの研削加工に対応するフルオートマチックグラインダ「DFG8541」を開発しました。本装置をSEMICON Japan 2022にて実機展示いたします(2022年12月14日~16日、東京ビッグサイト)。

開発背景
半導体市場におけるΦ8インチ以下のウェーハ研削ニーズに対し、当社はこれまでフルオートマチックグラインダDFG8540を展開してまいりました。同機は2軸研削のスタンダードモデルとして多くのデバイスメーカー、電子部品メーカーに納入されております。
一方で、同機のリリースから20年以上が経過し、顧客の加工対象はSiだけでなくSiCをはじめとする化合物半導体などにも拡大しました。また、高密度実装技術の進展に伴いウェーハ薄化へのニーズが高まっているなか、付着したパーティクルの挟み込みによる研削、搬送、洗浄時の割れリスクを低減させるため、装置内をより高い清浄度に保つことが求められています。
これらの背景を受け、高清浄度かつ安定した薄化研削と、作業性・生産性の向上を目的とした後継機DFG8541を開発しました。高トルクスピンドルをオプション化することでSiCなど硬度の高い難研削材料にも対応でき、世界的な脱炭素の動きで高まるSiCパワー半導体の製造ニーズにもお応えします。
製品特徴
高清浄度
以下の機能により装置内でのパーティクル付着を防ぎ、薄ウェーハの割れリスクを低減
- ウェーハセンタリング機構にカメラによる非接触方式を採用
-
各種洗浄機能を標準搭載
- チャックテーブルの二流体洗浄※1
- 加工後ウェーハのチャックテーブル上での二流体洗浄
- スピンナテーブルの二流体洗浄
- 加工後ウェーハのスピンナテーブル上での二流体洗浄
※1:加速したエアに液滴を混入し発生させたミストを洗浄面に高速で衝突させ、その際の衝撃波・膨張波によって低ダメージかつ高洗浄を実現する手法
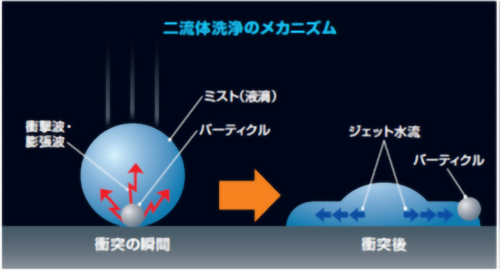
作業性・生産性向上
- 搭載モニタサイズを15インチ(DFG8540)から19インチに拡大(静電容量方式タッチパネルを採用)
- ウェーハ1枚ずつに加工レシピを設定できるため、レシピが混在していても連続加工が可能。少量多品種生産に対応
- チャックテーブル傾き調整用の電動軸を搭載することで、モニタ画面上での数値入力による加工形状補正を実現。調整時間を短縮
ウェーハ保護機能
開発品、最先端品やSiCなど高コストなウェーハの割れリスクを低減
- カセット内ウェーハの斜め入れをセンサで検知する「ウェーハマッピング」
- 表面保護テープの複数貼りなどの厚さ異常を事前に検知する「研削室投入前ウェーハ厚測定機能」
- ウェーハ搬送中の停電時に発動する「ウェーハ落下防止機能」
フットプリントの縮小
バキュームポンプを内蔵することにより、フットプリントを15%縮小(DFG8540比)

エア消費量の削減
新軸受け構成の採用により、エア消費量約50%削減(DFG8540比)。工場設備側(コンプレッサ)の消費電力低減にも貢献します。
装置概要
| 対応ワークサイズ | Φ100~200 mm |
|---|---|
| 構造 | 2スピンドル(加工軸)3チャックテーブル |
| 研削方式 | ワーク回転によるインフィード方式 |
| スピンドル | 定格出力4.2 kW(オプションで6.3 kW選択可能) |
| 回転数範囲1,000~7,000 min-1 | |
| 装置サイズ | W1,100 x D2,800 x H1,800 mm |
| 装置重量 | 2,900 kg |
今後の予定
| SEMICON Japan 2022出展 | 2022年12月14日~16日 |
|---|---|
| テストカット | 受付中 |
| 販売開始予定 | 2023年6月 |
株式会社ディスコについて
当社は、半導体や電子部品の製造に使用されるダイシングソーやグラインダなどの精密加工装置、および装置に取り付けて使用する精密加工ツールを提供する「半導体製造装置メーカー」です。これら製品に加え、装置とツールの利用技術の提供によりお客様の最適な加工結果を追求してきた結果、国内外のデバイスメーカーおよび半導体受託製造企業などに広く、当社製品・加工技術が採用されています。
詳細については、ウェブサイトwww.disco.co.jpをご覧ください。
お問い合わせ
株式会社ディスコ 広報室
