SDBG(Stealth Dicing Before Grinding)製程
解決方案
隨著智慧型手機以及平板電腦的薄型化、大容量化的發展,市場對快閃記憶體(Flash Memory)、內存控制器(Memory Controller)薄型化的要求也不斷提高,以往的製程面臨著極薄晶圓的搬運以及切割時的崩裂等課題。
SDBG製程在解決這些課題的同時,也可時間以下附加價值。
- 增加晶粒獲取數量
- 提高薄型晶粒的抗折強度
SDBG製程
SDBG製程是於隱形切割加工後進行背面研磨的技術,可實現薄型晶片的切割道狹窄化以及抗折強度的提升。
經由與分離擴片機(DDS Series)的組合運用,可將薄型晶片積層時作為接合材所使用的DAF(Die Attach Film)高品質分割。
製程流程
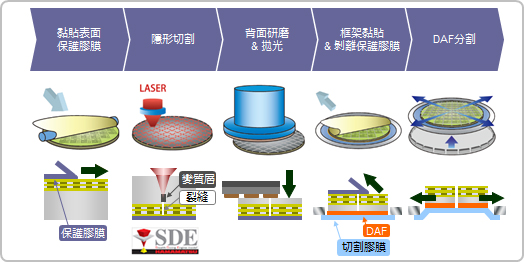
增加晶片獲取數量
使用隱型切割加工時,刀痕寬度幾乎為零,因此對切割道狹窄化大有貢獻。與通常的刀片切割製程相比,單位晶圓可獲取的晶片數量有望增加。
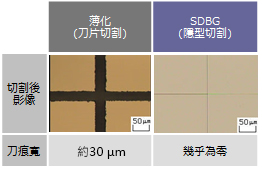
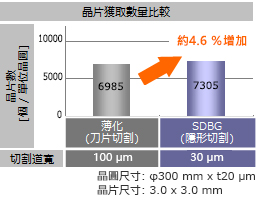
提高晶片抗折強度
刀片切割製程在晶片表面、背面造成的崩裂以及在晶片側面留下的加工痕,都對抗折強度有所影響。
SDBG為使用隱形切割加工在晶片內部形成變質層,再以變質層為起點進行分割,最後透過研磨將變質層除去的製程。
因此,SDBG製程不僅可以減少表面、背面的崩裂,並可製作出側面無加工痕的高強度的薄型晶片。
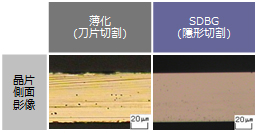
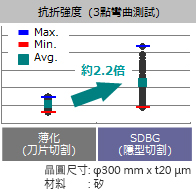
DAF(Die Attach Film)的高品質分割
使用分離擴片機(DDS Series)可將DAF在低溫環境下以擴展方式進行高品質分割。
擴展後切割膠膜的鬆弛問題可透過熱收縮使其回復,因此無需重新黏貼切割膠膜,可直接搬運至下一階段的鍵合製程。
相關情報
適用於SDBG製程的產品介紹
https://www.disco.co.jp/cn_t/products/index.html?id=sdbg

