高頻率電子元件中使用的GaAs(砷化鎵)等化合物半導體,在採用金剛石切割刀片進行切割(以下:刀片切割)時,切割速度慢、難以提高生產效率。
另外,在Sip(System in Package)等高集成化背景下,抗折強度高的薄片製造技術需求也浮出水面。然而,刀片切割中,隨著晶片由厚到薄,切割難度也越來越大。
為解決這些問題,迪斯科著眼於雷射切割機DFL7161的雷射頭和光學系統優化系統,利用雷射,確立了全切割應用技術。
應用技術
雷射全切割製程
本製程,是在厚度200 µm以下的薄型晶片上面(圖案面),用雷射照射1次或多次,切入膠帶,將晶片全切割的切割方法。因為雷射全切割可以加快切割速度,所以可以提高生產效率。

加工實例
GaAs化合物半導體的薄型晶片切割
GaAs晶片因為材料脆,在切割時容易發生破裂或缺損,所以以往的刀片切割速度很難得到提高。因為雷射全切割工序可以將切割刀片的切割速度提高10倍以上,所以可以提高生產效率。(切割速度僅為一例。實際操作時,因加工晶片不同會有所差異。)
採用雷射全切割製程,加工後切割槽寬度小,與刀片相比切割槽損失少,可以減小晶粒間隔。對於小型晶粒切割中,加工線條數會增加的化合物半導體晶片而言,通過實現減小晶粒間隔,1枚晶片可生產的晶粒個數會得到相應提高。
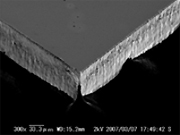
※ GaAs加工時,要使用附加設備,用於除去氣化As氣體的裝置。
薄型化矽晶片的全切割加工
伴隨著晶片薄型化,切割時的崩裂或裂縫對晶粒強度也有很大影響。因此,需要有可以進一步抑制崩裂現象的加工方法,切割的難度也越來越大。另外,伴隨著薄型化晶粒粘貼膠膜DAF(Die Attach File)使用的增加,對背面粘貼DAF的晶片,通過抑制毛邊等現象進行高品質切割,也是一個重要的課題。
針對這些課題,迪思科確立了包括矽的薄型晶片切割解決方案在內的雷射全切割應用技術。雷射全切割,利用雷射的高速加工,使UPH得以提高。另外,附有DAF的矽晶片,矽和DAF一起或單獨切割均可。
-
矽晶片
晶粒上面照片
-
附DAF的矽晶片
晶粒側面照片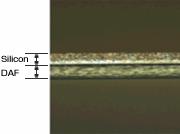
其他雷射全切割加工實例
背面附金屬膜的矽晶片、GaP(磷化鎵)晶片、InP(磷化銦)晶片、GaN(氮化鎵)晶片、Ge(鍺)晶片等。
對應機種
本產品為,將Low-k膜開槽加工中獲得廣泛好評,可對應Φ300 mm晶片的全自動雷射切割機DFL7161的雷射頭和光學系統再次優化後,用於雷射全切割的裝置。



